В чистом виде ионный синтез скрытых слоев SiO2 в подложке кремния в рамках промышленных технологий КНИ- структур был впервые использован при разработке SIMOX-процесса (Separation by Implantation of Oxygen), при котором процесс имплантации ионов кислорода О+ в подложку кремния производился со стехиометрическими дозами ~(1,2÷2)·1018О+/см-2 [1]. Последовавшие модификации SIMOX процесса – дополнительное высокотемпературное окисление скрытого изолятора ITOX (Internal Thermal Oxidation), двухэтапная имплантация и инженерия дефектов DIBOX (Defect-Induced Buried Oxide) – позволили перейти к существенно меньшим (достехиометрическим) дозам ~(3÷7)·1017О+/см2 [2]. Хотя качество структур при этом повышалось, однако температурный бюджет процесса оставался неизменно высоким (температуры свыше ~1320 °С и длительность отжига более 5 часов). Ведь только при этих режимах могло происходить полное растворение преципитатов SiOх в слое кремния и сформироваться резкая граница Si–SiO2. Высокий термический бюджет отжига являлся препятствием и для синтеза локальных КНИ в рамках МДП технологии самосовмещения на обычных кремниевых подложках, где с помощью локальных КНИ можно реализовать ряд интересных конструктивно-технологических решений, например изготовление полевого транзистора [3]. Здесь процесс формирования затвора совмещен с изготовлением маски для последующей имплантации кислорода, поэтому синтез скрытых локальных слоев (слева и справа от затвора) проводят уже при сформированной его структуре. Чтобы избежать деградации подзатворного диэлектрика, такой подход можно реализовать только в условиях низкотемпературного синтеза.
Минимизации дозы имплантированного кислорода при достижении наименьшего уровня оборванных связей между атомами, участвующими в ионном синтезе, можно добиться в структуре стекла, как материала захороненного слоя. При этом резко снижается термический бюджет постимплантационных термообработок, так как температуры размягчения стекол в широком диапазоне составов не превышают 1000°С. Меняя дозу ионов веществ- стеклообразователей, т.е. состав стекла, плавно регулируются константы термического расширения захороненного слоя и другие его физико-механические свойства. При этом легирующие свойства и диэлектрические параметры стекол, известных по применению в микроэлектронике (например, боросиликатных), могут целенаправленно использоваться при выборе материала захороненного слоя. В свою очередь, стекла являются геттерами примесей, дефектов и хорошо согласованы с кремнием по коэффициентам термического расширения.
На основе данных соображений, была предложена новая технология формирования КНИ- структур методом ионного синтеза [4]. Ее суть заключалась в двухстадийной имплантации сначала ионов кислорода в достехиометрической дозе, и затем, примерно на ту же глубину, ионов стеклообразователя. В нашем эксперименте имплантация кислорода О2+ (в молекулярном виде) проводилась в кремниевые пластины КЭФ-4,5 (100) с энергией 300 кэВ и дозой 3,4·1017 см-2 . После этого пластины отжигали при температуре 900°С в атмосфере сухого О2 в течение 5 минут. Затем проводили имплантацию бора при энергии ионов В+ 100 кэВ, доза имплантации 8·1016 см-2. Затем пластины снова подвергали отжигу-отпуску при 900°С в атмосфере сухого О2 в течение 5 минут и проводили серию технологических отжигов при температуре 1075°С. Полученные структуры подвергались послойному Оже- анализу содержания кислорода на установке PHI 660 Perkin Elmer. Энергия пучка первичных электронов составляла 10 кэВ. Удаление слоев в процессе измерений проводилось с помощью пучка ионов азота N2+ c энергией 9 кэВ, фиксировались интенсивности основных Оже – пиков: KLL – для кремния, LMM – для кислорода. Растровая электронная микроскопия (РЭМ) проводилась на установке LEO-430.
Как можно заключить из полученных Оже- измерений на рис. 1, присутствие бора способствовало “стягиванию” кислорода до атомных концентраций, приблизительно соответствовавших SiO2 – 65 ат.%. На рис. 2а. представлена интенсивность Оже- сигнала кислорода для контрольного образца (без имплантации бора), подвергнутого отжигу – 1075°С, 7 минут. Максимум концентрации кислорода соответствует всего 27%, т.е. степень насыщения кислородом в исходном максимуме была недостаточна для образования тонкого однородного слоя диэлектрика стехиометрического состава (66% – для диоксида кремния). На рис. 1б. представлены результаты послойного Оже-анализа образца с дополнительной имплантацией бора. Толщина растущего скрытого слоя диэлектрика увеличивалась за счет образования дополнительной боросиликатной фазы, что наглядно доказывает ускоренный способ формирования скрытого слоя при достехиометрических дозах кислорода. Очевидно, что в присутствии бора при тех же температурах происходила смена диффузионного контроля процесса кинетическим контролем вследствие возрастания коэффициента диффузии окислителя к формирующейся границе раздела. Физически это можно объяснить “разрыхлением” сетки связей Si–O формирующейся боросиликатной фазой, где доставка кислорода в зону реакции могла быть облегчена образованием подвижных комплексов кислород-бор. Другой причиной ускорения роста фазы с составом, близким к стехиометрическому составу диоксида кремния, является окислительно-восстановительная реакция, идущая в две стадии, по схеме 4В + 3О2=2В2О3 и 2В2О3 + 3Si = 3SiO2 + 4B. Бор здесь окисляется легче, чем кремний, и может выступать в роли активатора процесса окисления [5]. Образование обогащенного бором отсеченного слоя со скрытой силикатной прослойкой фиксировалось методом РЭМ (рис.2). Материал этой прослойки по химическим свойствам заметно отличался от диоксида кремния, в частности, чрезвычайной высокой стойкостью к воздействию чистой плавиковой кислоты.
Таким образом, скрытые слои силикатных стекол формировались при общих дозах имплантированных элементов, по крайней мере, в два раза ниже, чем доза кислорода в традиционном высокодозовом SIMOX процессе. Температуры термообработки снижаются по крайней мере на 300°С, при этом времена термообработок исчисляются минутами, а не часами. Такое заметное снижение температурного бюджета синтеза может быть использовано для новых применений технологий КНИ, например, при изготовлении МДП кремниевых приборов, микромеханике, а также при создании новых наноматериалов.
Рисунок 1. −Интенсивность сигналов от Оже-пиков кислорода и кремния (подложка) после имплантации и отжига 1075 °С, 7 минут (а,б). Рис. 1а − при имплантации только молекулярного O2+ с дозой 3,4·1017 см-2. Рис.1б − при имплантации дополнительно одиночных ионов B+ с дозой 8·1016 см-2
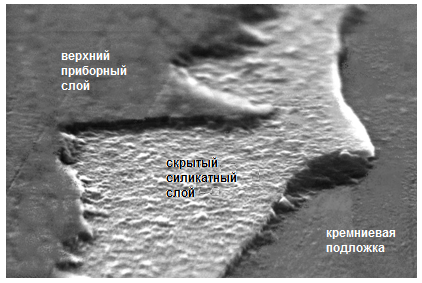
Рисунок 2. – РЭМ-изображение структуры c верхним отсеченным и изоляционным силикатным слоями на кремниевой подложке после лазерной обработки и химического травления.
Список литературы:
- Steve Krause, Maria Anc, Peter Roitman. Evolution and Future Trends of Simox Material // MRS Bulletin. – 1998. V. 23. N12. P.25-29.
- Tae-Hun Shim, Shin-Deuk Kim, Suk-Goo Kim, et al. Determination of the distribution and morphology of silicon islands in the buried oxide layer of SOI wafers by using a focused ion beam and transmission electron microscope // J. of the Korean Phys. Soc. – 2004. V.45. N4. P.1074-1077.
- Патент России 2193803, Н 01 L 21/76, приоритет от 09.01.2001 (RU Patent № 2193803, 2001, Jan. 09.)
- Krivelevich S.A., Buchin Ed.Yu., Denisenko Yu.I., Selyukov R.V. Diffusion and phase formation in ternary silicate systems framed by an ion bombardment // Proc. of SPIE – 2005. V.6260. 626007.
- Угай Я.А., Анохин В.З., Миттова И.Я, и др. Инициированное окисление кремния // Изв. АН СССР. Сер. Неорган. Материалы. – 1974, Т.10. N4. C. 726-729.

